利用方法
利用手順
技術相談・依頼を受けた後の対応体制は、以下のような流れとなっております。
1.利用相談
装置一覧 で装置仕様をご確認いただき、利用内容をメール・電話などでご相談ください。
E-mail: staff[at]u-tsukuba-arim.jp
Phone: 029-853-5804
2.利用申請書の提出
支援の内容が決まりましたら、利用登録申請書に必要事項を記載し、事務局に提出してください。
3.審査
課題選定・評価委員会にて審査を行います。
4.利用許可通知、支援開始
審査結果をメールで通知し、許可が下りると支援が開始されます。
5.成果報告書の提出、料金のお支払
支援終了後または年度末に利用報告書を提出いただきます。
利用時間に応じて課金します。
利用料金
装置の利用料金
料金は各装置の利用時間(予約時間)に応じた時間課金従量制です。
毎月の利用に応じた積算額を翌月請求させていただきます。
*ご予約は30分単位で受付けています。
*技術補助・技術代行の料金は、機器利用料金を含みます。
| 共用装置名 装置名をクリックすると装置の詳細ページに移動します。 |
学外利用者 料金 / 1時間 |
学内利用者 料金 / 1時間 |
|
|---|---|---|---|
| 機器利用 | 技術補助・技術代行 | ||
| デバイスシミュレーター | 1,720円 | 7,400円 | 660円 |
| スパッタリング装置 | 3,400円 | 9,000円 | 1,500円 |
| FIB-SEM | 11,360円 | 17,000円 | 4,500円 |
| 電子線蒸着装置 | 3,080円 | 8,800円 | 1,500円 |
| 電子線描画装置 | 3,360円 | 9,000円 | 1,500円 |
| 走査型プローブ顕微鏡 | 3,480円 | 9,000円 | 1,500円 |
| ウェハーダイシングマシン | 1,300円 | 7,000円 | 600円 |
| 電界放出型走査電子顕微鏡 | 3,560円 | 9,200円 | 1,500円 |
| パターン投影リソグラフィシステム | 1,060円 | 6,600円 | 500円 |
| インクジェットパターン形成装置 | 2,940円 | 8,600円 | 1,500円 |
| 反応性イオンエッチング | 1,860円 | 7,400円 | 1,080円 |
| 触針式表面段差計 | 420円 | 6,000円 | 200円 |
| 半導体特性評価システム(B1500A) | 1,020円 | 6,600円 | 300円 |
| 光電子分光装置 | 2,320円 | 8,000円 | 400円 |
| パワーデバイス特性評価装置(B1505A) | 1,640円 | 7,200円 | 400円 |
| IRエミッション顕微鏡 | 4,120円 | 9,800円 | 1,000円 |
| 10kV計測システム | 2,800円 | 8,400円 | 1,000円 |
| イオンミリング | 2,620円 | 8,200円 | 1,000円 |
| 分光エリプソメータ | 1,500円 | 7,200円 | 800円 |
| 小型イオンシャワー(終点検出器付きイオンミリング) | 2,260円 | 7,800円 | 1,500円 |
| 多機能走査型X線光電子分光分析装置 | 4,740円 | 10,400円 | 1,000円 |
| データ解析用PC | 500円 | 6,200円 | 200円 |
*2024年4月1日より適用 (税込表示)
設置場所
装置の設置場所
共同研究棟C 107室

| 装置分野 | 装置名 |
|---|---|
| 加工・観察 | FIB-SEM (FEI,Helios NanoLab 600i) |
| 観察 | FE-SEM (日立ハイテク,SU-8020) |
| 露光 | 電子線描画装置 (ELIONIX,ELS-7500EX) |
| 露光 | マスクアライナー (Neutronix-Quintel, Q 2001CT) |
| 露光 | パターン投影リソグラフィーシステム(Heidelberg Instruments, µPG501) |
| 成膜 | インクジェットパターン生成装置(SIJテクノロジ, ST050) |
| シミュレータ | プロセス/デバイスシミュレーター (SILVACO,ATHENA/ATLAS) |
| その他 | プラズマリアクター (ヤマト科学, PR500) / スピンコーター(ミカサ株式会社, MS-A100) |
共同研究棟C 104室

| 装置分野 | 装置名 |
|---|---|
| 観察・分析 | AFM (Bruker, Multimode8) (Bruker,Dimension Icon) |
| 分析 | SNOM (日本分光,特注) |
| 分析 | レーザラマン分光光度計 (日本分光, NRS-5100) |
共同研究棟C 301室
| 装置分野 | 装置名 |
|---|---|
| 分析 | 半導体特性評価システム(Agilent, B1599T) |
| 分析 | 触針式表面形状測定器(アルバック, Dektak) |
共同研究棟C 309室
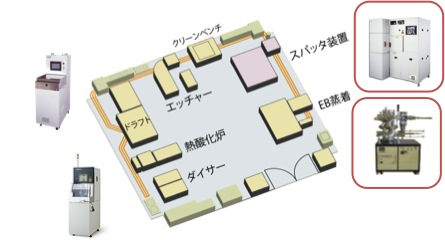
| 装置分野 | 装置名 |
|---|---|
| 成膜 | スパッタリング装置 (芝浦メカトロニクス, CFS-4FP-LL) |
| 成膜 | 多元電子ビーム蒸着装置(株式会社エイコー, EB-350T) |
| 加工 | 反応性イオンエッチング装置(サムコ株式会社, RIE-10NR) |
| 切削 | ウェーハダイシングマシン(株式会社ディスコ, DAD322) |
